МОП-транзисторы
В программе PSpice полевые транзисторы с изолированным затвором (МОП-транзисторы, MOSFET) описываются шестью разными системами уравнений, выбор которых определяется параметром LEVEL, принимающим значения 1, 2, 3, 4, 5 и 6 [4, 7, 30, 33, 37, 43, 54, 59, 73, 76, 77, 82]. Модель первого уровня (LEVEL=1) используется в тех случаях, когда не предъявляются высокие требования к точности моделирования вольт-амперных характеристик транзистора, в частности при моделировании МОП-транзисторов с коротким или узким каналом. Модели второго (LEVEL=2) и третьего (LEVEL=3) уровней учитывают более тонкие физические эффекты. Параметры модели четвертого – шестого уровней (LEVEL=4–6) рассчитываются по справочным данным с помощью специальной программы идентификации [73]. Структура МОП-транзистора приведена на рис. 4.8. Все модели имеют одну и ту же эквивалентную схему, изображенную на рис. 4.9, а.
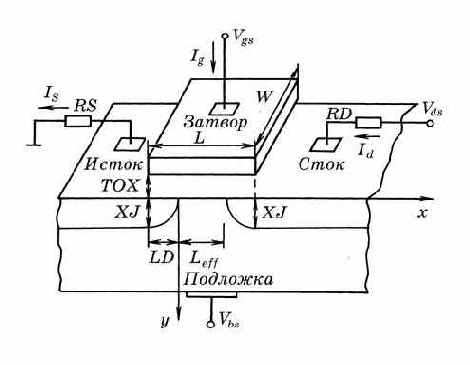 Рис. 4.8. Структура МОП-транзистора с каналом n-типа |

Рис. 4.9. Нелинейная (а) и линейная (б) схемы замещения МОП-транзистора с каналом n-типа |
Параметры модели МОП-транзистора уровней 1–4 приведены в табл. 4.5 (параметры моделей более редко использующихся уровней 5–6 даны в [59]).
| Имя параметра | Уровень модели LEVEL | Параметр | Значение по умолчанию | Единица измерения | |||||
| LEVEL | Индекс модели | 1 | |||||||
| L | 1–4 | Длина канала | DEFL | м | |||||
| W | 1–4 | Ширина канала | DEFW | м | |||||
| LD | 1–3 | Длина области боковой диффузии | 0 | м | |||||
| WD | 1–3 | Ширина области боковой диффузии | 0 | м | |||||
| VTNOM | 1–3 | Пороговое напряжение при нулевом смещении подложки Vbs=0 | 1 | В | |||||
| KP | 1–3 | Параметр удельной крутизны | 2·10 | А/В | |||||
| GAMMA | 1–3 | Коэффициент влияния потенциала подложки на пороговое напряжение | вычисляется |  | |||||
| PHI | 1–3 | Поверхностный потенциал сильной инверсии | 0,6 | В | |||||
| LAMBDA | 1, 2 | Параметр модуляции длины канала | 0 | 1/В | |||||
| RD | 1–4 | Объемное сопротивление стока | 0 | Ом | |||||
| RS | 1–4 | Объемное сопротивление истока | 0 | Ом | |||||
| RG | 1–4 | Объемное сопротивление затвора | 0 | Ом | |||||
| RB | 1–4 | Объемное сопротивление подложки | 0 | Ом | |||||
| RDS | 1–4 | Сопротивление утечки сток–исток |  | Ом | |||||
| RSH | 1–4 | Удельное сопротивление диффузионных областей истока и стока | 0 | Ом/кв. | |||||
| IS | 1–4 | Ток насыщения p–n-перехода сток-подложка (исток–подложка) |  | А/м | |||||
| JS | 1–4 | Плотность тока насыщения перехода сток (исток) –подложка | 0 | ||||||
| JSSW | 1–4 | Удельная плотность тока насыщения (на длину периметра) | 0 | А/м | |||||
| PB | 1–4 | Напряжение инверсии приповерхностного слоя подложки | 0,8 | В | |||||
| PBSW | 1–4 | Напряжение инверсии боковой поверхности p–n-перехода | PB | В | |||||
| N | 1-4 | Коэффициент неидеальности перехода подложка–сток | 1 | ||||||
| CBD | 1–4 | Емкость донной части перехода сток-подложка при нулевом смещении | 0 | Ф | |||||
| CBS | 1–4 | Емкость донной части перехода исток-подложка при нулевом смещении | 0 | Ф | |||||
| CJ | 1–4 | Удельная емкость донной части p–n-перехода сток (исток) –подложка при нулевом смещении (на площадь перехода) | 0 | Ф/м | |||||
| CJSW | 1–4 | Удельная емкость боковой поверхности перехода сток (исток) –подложка при нулевом смещении (на длину периметра) | 0 | Ф/м | |||||
| MJ | 1-4 | Коэффициент, учитывающий плавность перехода подложка-сток (исток) | 0,5 | ||||||
| MJSW | 1–4 | Коэффициент наклона боковой поверхности перехода подложка–сток (исток) | 0,3 | ||||||
| FC | 1–4 | Коэффициент нелинейности барьерной емкости прямосмещенного перехода подложки | 0,5 | ||||||
| CGSO | 1–4 | Удельная емкость перекрытия затвор–исток (за счет боковой диффузии) | 0 | Ф/м | |||||
| CGDO | 1–4 | Удельная емкость перекрытия затвор–сток на длину канала (за счет боковой диффузии) | 0 | Ф/м | |||||
| CGBO | 1–4 | Удельная емкость перекрытия затвор–подложка (за счет выхода затвора за пределы канала) | 0 | Ф/м | |||||
| TT | 1–4 | Время переноса заряда через p–n-переход | 0 | с | |||||
| NSUB | 1–3 | Уровень легирования подложки | нет | 1/см | |||||
| NSS | 2,3 | Плотность медленных поверхностных состояний на границе кремний-подзатворный оксид | нет | 1/см | |||||
| NFS | 2,3 | Плотность быстрых поверхностных состояний на границе кремний-подзатворный оксид | 0 | 1/см | |||||
| TOX | 1–3 | Толщина оксида | вычисляется | м | |||||
| TPG | 2,3 | Легирование затвора (+1 – примесью того же типа, каки для подложки; –1 – примесью противоположного типа; 0 – металл) | +1 | ||||||
| XJ | 2,3 | Глубина металлургического перехода областей стока и истока | 0 | м | |||||
| UO | 1–3 | Подвижность носителей тока в инверсном слое канала | 600 | см | |||||
| UCRIT | 2 | Критическая напряженность вертикального поля, при которой подвижность носителей уменьшается в два раза | 10 | В/см | |||||
| UEXP | 2 | Эмпирическая константа, определяющая подвижность носителей | 0 | ||||||
| VMAX | 2,3 | Mаксимальная скорость дрейфа носителей |  | м/с | |||||
| NEFF | 2 | Эмпирический коэффициент коррекции концентрации примесей в канале | 1 | ||||||
| XQC | 2,3 | Доля заряда канала, ассоциированного со стоком | 0 | ||||||
| DELTA | 2,3 | Коэффициент влияния ширины канала на пороговое напряжение | 0 | ||||||
| THETA | 3 | Kоэффициент модуляции подвижности носителей под влиянием вертикального поля | 0 | 1/В | |||||
| ETA | 3 | Параметр влияния напряжения сток–исток на пороговое напряжение (статическая обратная связь) | 0 | ||||||
| KAPPA | 3 | Параметр модуляции длины канала напряжением сток–исток | 0,2 | ||||||
| KF | 1–4 | Коэффициент, определяющий спектральную плотность фликкер–шума | 0 | ||||||
| AF | 1–4 | Показатель степени, определяющий зависимость спектральной плотности фликкер–шума от тока через переход | 1 | ||||||
| T_MEASURED | 1–4 | Температура измерений |  | ||||||
| T_ABS | 1–4 | Абсолютная температура |  | ||||||
| T_REL_GLOBAL | 1–4 | Относительная температура |  | ||||||
| T_REL_LOCAL | 1–4 | Разность между температурой транзистора и модели-прототипа |  |
По умолчанию, если параметр LEVEL не указан при описании модели, используется модель МОП-транзистора первого типа.
Параметры, характерные только для модели МОП-транзистора четвертого типа, приведены в табл. 4.6.
Таблица 4.6
|
Имя параметра |
Параметр |
Единица измерения |
|
DL |
Уменьшение эффективной длины канала |
 |
|
DW |
Уменьшение эффективной ширины канала |
 |
|
TOX |
Толщина оксида затвора |
 |
|
VFB |
Напряжение плоских зон |
В |
|
PHI |
Контактная разность потенциалов инверсного слоя перехода |
В |
|
K1 |
Коэффициент влияния подложки |
 |
|
K2 |
Коэффициент разделения заряда обедненной области между стоком и истоком |
|
|
ETA |
Коэффициент, отражающий зависимость порогового напряжения от смещения подложка–сток |
|
|
X2E |
Чувствительность уровня индуцированного слоя к смещению на подложке |
В |
|
X3E |
Чувствительность уровня индуцированного слоя к смещению на стоке при Vds=Vdd |
В |
|
MUZ |
Подвижность носителей при нулевом смещении |
см |
|
X2MZ |
Чувствительность подвижности носителей к смещению на подложке при Vds=0 |
см  |
|
UO |
Коэффициент, отражающий изменение подвижности от напряженности вертикального поля |
В |
|
X2UO |
Чувствительность критической подвижности носителей к смещению на подложке |
В |
|
U1 |
Коэффициент, определяющий степень насыщения скорости носителей от напряжения на стоке |
 |
|
X2U1 |
Чувствительность максимальной скорости носителей к напряжению смещения на подложке |
  |
|
X3U1 |
Чувствительность максимальной скорости носителей к напряжению смещения на стоке при Vds=Vdd |
  |
|
MUS |
Подвижность носителей при нулевом смещении на подложке и Vds=Vdd |
см  |
|
X2MS |
Чувствительность подвижности носителей к смещению на подложке при Vds=0 |
см  |
|
X3MS |
Чувствительность подвижности носителей к смещению на стоке при Vds=Vdd |
см  |
|
NO |
Коэффициент наклона проходной характеристики в субпороговом режиме при нулевом смещении на подложке |
|
|
NB |
Чувствительность коэффициента наклона проходной характеристики в субпороговом режиме к смещению на подложке |
|
|
ND |
Чувствительность коэффициента наклона проходной характеристики в субпороговом режиме к смещению на стоке |
|
|
TEMP |
Температура, при которой измерены параметры транзистора |
 |
|
VDD |
Коэффициент влияния напряжения смещения |
|
|
XPART |
Флаг, определяющий распределение зарядов между стоком и истоком (при XPART=0 устанавливается соотношение зарядов сток-исток, равное 40/60, при XPART=1 – соотношение 0/100) |
|
|
WDF |
Ширина переходов стока и истока по умолчанию |
м |
|
DELL |
Уменьшение ширины переходов стока и истока по умолчанию |
м |
Здесь Vdd – напряжение, при котором проводятся измерения (обычно оно равно напряжению питания).
При включении МОП-транзистора в схему можно указать значения необязательных параметров (см. табл. 4.7).
Таблица 4.7
|
Обозначение |
Параметр |
Значение по умолчанию |
Размерность |
|
L |
Длина канала DEFL |
м |
|
|
W |
Ширина канала DEFW |
м |
|
|
AD |
Площадь диффузионной области стока DEFAD |
м |
|
|
AS |
Площадь диффузионной области истока DEFAS |
м |
|
|
PD |
Периметр диффузионной области стока |
0 |
м |
|
PS |
Периметр диффузионной области истока |
0 |
м |
|
NRD |
Удельное относительное сопротивление стока |
1 |
|
|
NRS |
Удельное относительное сопротивление истока |
1 |
|
|
NRG |
Удельное относительное сопротивление затвора |
0 |
|
|
NRB |
Удельное относительное сопротивление подложки |
0 |
|
|
M |
Масштабный коэффициент |
1 |
|
В последующем описании моделей МОП-транзисторов используются следующие физические константы:
EPS0=8,86·10

EPSox=3,9·EPS0 – диэлектрическая проницаемость оксида;
EPSsil=11,7·EPS0 – диэлектрическая проницаемость кремния;
q=1,60·10

k=1,38·10


Vt=kT/q – температурный потенциал p–n-перехода.
Приведем далее соотношения, общие для всех моделей МОП-транзистора:
крутизна управления по затвору KP=UO·Cox;
крутизна проходной характеристики МОП-транзистора Beta=0,5·KP·W/L;
удельная емкость окисла Cox=EPSox/TOX;
коэффициент влияния потенциала подложки на пороговое напряжение

поверхностный потенциал
PHI=2Vt·ln(Na/Ni),
где Na=10

– собственная концентрация носителей, определяемая уравнением
Ni





Fp=


VTNOM=Vi


Vbi=Ws-10

Ws=Wg-(Fp+3,25+0,5·EG),

где Vbi, Ws – ширина запрещенных зон подложки и неметаллического оксида,
Eg=1,16-0,000702·T



Leff=L-2·LD – эффективная длина канала;
Weff=W-2·WD – эффективная ширина канала;
CGBO=Cox·Leff – удельная емкость перекрытия затвор–подложка;
CGDO=Cox·Ldd – удельная емкость перекрытия затвор–сток;
CGSO=Cox·Lds – удельная емкость перекрытия затвор–исток, где Ldd и Lds – длины боковых поверхностей диффузии в областях стока и истока; очевидно, что для большинства транзисторов CGDO=CGSO;
CJSW=CJ·LD – удельная емкость боковой поверхности перехода;
CBS=CJ·AS – емкость перехода исток-подложка при нулевом смещении;
CBD=CJ·AD – емкость перехода сток-подложка при нулевом смещении.
Пользователь может задать значения CBS и CBD либо AS и AD. Если эти параметры не заданы, то они приравниваются нулю.
Параметры электрических схем замещения KP, GAMMA, PHI и пр. рассчитываются по приведенным выше формулам через физические параметры NSUB, TOX и др., если в описании модели МОП-транзистора с помощью директивы .MODEL отсутствует какой-либо параметр.
Статический режим МОП-транзистора. Модели всех типов характеризуются нулевым током затвора Ig=0 и током подложки
Ib = Ibs + Ibd,
где Ibs и Ibd – токи переходов подложка-исток и подложка–сток,
Ibs = Iss·[exp(Vbs/(N·Vt))-1],
Ibd = Ids·[exp(Vbd/(N·Vt))-1].
При задании нулевого значения одного из параметров JS, AS или AD принимают Iss=Ids=IS, в противном случае Iss=AS·JS+PS·JSSW, Ids=AD·JS+PD·JSSW. Ток стока Id=Ibd–Idrain, ток истока Is=Ibs+Idrain.
Ток Idrain определяется следующими соотношениями.
1. Для модели LEVEL=1 в нормальном режиме (Vds


где Beta=0,5·KP·W/L – крутизна проходной характеристики МОП-транзистора;

Пороговое напряжение положительно (отрицательно) в режиме обогащения и отрицательно (положительно) в режиме обеднения для транзистора с n-каналом (p-каналом).
Для области обратного смещения (Vds < 0)


где Vto = VTNOM+GAMMA·

Параметр LAMBDA характеризует наклон выходной характеристики транзистора в области насыщения. В соответствии с рис. 4.10 он определяется из уравнения

 Рис. 4.10. К определению параметра LAMBDA |
где Vd1=Vto+1 В, Vd2=Vto+3 В при Vgs=Vto+1 В.
Крутизна МОП-транзистора KP определяется в основном подвижностью носителей, толщиной и материалом подзатворного диэлектрика. Поскольку в модели первого уровня параметры технологического процесса игнорируются, задание значений TOX и UO не изменяет значение KP. По умолчанию KP=20 мкА/В




Параметры VTO, GAMMA и KP определяются из экспериментальных данных (рис. 4.11) по формулам

Аналитическая зависимость GAMMA от параметров материала приведена выше.
 Рис. 4.11. К определению параметров VTNOM, GAMMA и KP |

Коэффициент



Влияние ширины канала учитывается с помощью коэффициента
ETA=1+0,25

Температурная зависимость напряжения порога учитывается с помощью коэффициента
XN=1+q·10


+ 0,25·[(PHI+Vds-Vbs)/

+ (PHI-Vbs)/

Выражения для тока стока Idrain здесь не приводятся из-за их сложности [33, 82].
3. Для модели LEVEL=3 используются полуэмпирические уравнения статических характеристик МОП-транзистора. Пороговое напряжение полагается равным
Vto = VTNOM-


где



Fs – коэффициент, учитывающий влияние геометрии прибора на укорочение канала;
Fn=0,5·DELTA·

XN=1+0,5·(GAMMA·Fs·

+ q·10

Эффективная подвижность носителей с учетом напряженности поля в канале равна

где

Напряжение насыщения определяется по формуле
VDsat =

где параметр


Fb = Fn+0,5·GAMMA·Fs/

Эффективная длина канала определяется соотношением
Leff =

где


A=KAPPA·(Vds-VDsat) ·
Ток Idrain определяется из выражений

3. Для уровня LEVEL=4 используется модель BSIM (Berkeley Short-channel IGFET Model) – короткоканальная модель полевого транзистора с изолированным затвором, разработанная в Калифорнийском университете (г. Беркли). По сравнению с моделью первого уровня учитываются следующие эффекты [76]:
– зависимость подвижности носителей от вертикального поля;
– насыщение скорости носителей;
– зависимость порогового напряжения от напряжения стока;
– распределение заряда обедненной области между стоком и истоком;
– неоднородное легирование для транзисторов, изготовленных с применением ионной имплантации%
– модуляция длины канала;
– подпороговая проводимость;
– зависимость всех параметров от геометрии транзистора.
В модели BSIM ток стока представляется суммой токов сильной и слабой инверсии (подпороговый режим):
Idrain = Idrain


Это позволяет обеспечить непрерывность первых производных и за счет этого значительно улучшить сходимость расчета статического режима по сравнению с моделями 2- и 3-го уровня.
В режиме сильной инверсии пороговое напряжение определяется выражением
Vto = VFB + PHI + K1


Параметр K1 сходен с параметром GAMMA в модели первого уровня. Параметры К1, К2 совместно моделируют неоднородность легирования. Параметр ETA частично моделирует уменьшение длины канала и порогового напряжения из-за статической индукции.
Ток стока в режиме сильной инверсии определяется следующими соотношениями.
В режиме отсечки (Vgs


В линейной области (Vgs>Vto и 0<Vds<VDsat)

где

Непривычный вид формулы для параметра a
связан с тем, что применена дробно-полиномиальная аппроксимация хорошо известной трансцендентной зависимости a=2/3·[(Vds+PHI-Vbs)


В режиме насыщения (Vgs>Vto и Vds


где

носителей,
VDsat = (Vgs - Vto)/(a

Составляющая тока стока за счет слабой инверсии равна

где

Показатель степени 1,8 выбран экспериментально для наилучшей совместимости с составляющей тока сильной инверсии. Параметры подпорогового режима N0, NB и ND определяют коэффициент наклона подпороговой характеристики
n = N0 + NB·Vbs + ND·Vds.
Параметры VFB, PHI, K1 и K2 считаются не зависимыми от режима по постоянному току. Остальные параметры рассчитываются по формулам
U

U


где Vdd – напряжение питания, при котором измерялись параметры транзистора.
Зависимость параметра



Динамические свойства МОП-транзистора. Они учтены включением в модель емкости обедненного слоя подложка– исток Cbs и емкости обедненного слоя подложка– сток Cbd. Эти емкости складываются из емкости данной поверхности и боковой поверхности переходов. Если параметры CBS и CBD не заданы (по умолчанию они полагаются равными нулю), то эти емкости рассчитываются по формулам
Cbs = AS·CJ·Cbsj+PS·CJSW·Cbss+TT·Gbs;
Cbd = AD·CJ·Cbdj+PD·CJSW·Cbds+TT·Gds.
В противном случае (т.е. при заданных абсолютных значениях CBS и CBD)
Cbs = CBS·Cbsj+PS·CJSW·Cbss+TT·Gbs;
Cbd = CBD·Cbdj+PD·CJSW·Cbds+TT·Gds,
где Gbs=dIbs/dVbs, Gds=dIbd/dVbd – дифференциальные проводимости в окрестности рабочей точки.
Скалярные множители, отражающие зависимость барьерных емкостей от напряжений смещения, рассчитываются следующим образом:
при Vbs

Cbsj = (1-Vbs/PB)

Cbss = (1-Vbs/PBSW)

при Vbs>FC·PB
Cbsj = (1-FC)

Cbss = (1-FC)

при V

Cbdj = (1-Vbd/PB)

Cbds = (1-Vbd/PBSW)

при Vbd>FC·PB
Cbdj = (1-FC)

Cbds = (1-FC)

Емкости затвор– исток, затвор– сток и затвор– подложка рассчитываются по формулам Cgs=CGSO·W, Cgd=CGDO·W, Cbd=CGBO·L.
Температурные зависимости параметров элементов эквивалентной схемы МОП-транзистора учитываются с помощью следующих выражений:
IS(T)=IS·exp{[EG(Tnom) ·T/Tnom-EG(T)]/Vt};
JS(T)=JS·exp{[EG(Tnom) ·T/Tnom-EG(T)]/Vt};
JSSW(T)=JSSW·exp{[EG(Tnom) ·T/Tnom-EG(T)]/Vt};
PB(T)=PB·T/Tnom-3Vt·ln(T/Tnom)-EG(Tnom) ·T/Tnom+EG(T);
PBSW(T)=PBSW·T/Tnom-3Vt·ln(T/Tnom)-EG·T/Tnom+EG(T);
PHI(T)=PHI·T/Tnom-3Vt·ln(T/Tnom)-EG(Tnom) ·T/Tnom+EG(T);
EG(T) = 1,16-0,000702·T

CBD(T)=CBD{1+MJ [0,0004 (T-Tnom)+1-PB(T)/PB]};
CBS(T)=CBS{1+MJ [0,0004(T-Tnom)+1-PB(T)/PB]};
CJ(T)=CJ{1+MJ [0,0004 (T-Tnom)+1-PB(T)/PB]};
CJSW(T)=CJSW{1+MJSW [0,0004 (T-Tnom)+1-PB(T)/PB]};
KP(T)=KP(T/Tnom)


KF(T)=KF·PB(T)/PB; AF(T)=AF·PB(T)/PB,
где Tnom – номинальная температура, при которой измерены параметры транзистора; T – текущая температура.
Линейная схема замещения МОП-транзистора. На рис. 4.9, б она приведена с источниками внутренних шумов. Тепловые шумы Iш




и RD, имеют спектральные плотности S




Источник тока Iшd, характеризующий дробовой и фликкер-шум, имеет спектральную плотность
S


где Gm = dIdrain/dVgs
– дифференциальная проводимость в рабочей точке по постоянному току; Kchan=(Leff)

В качестве примера приведем описание модели МОП-транзистора IRF140, используя модель третьего типа
.model IRF140 NMOS (LEVEL=3 GAMMA=0 DELTA=0 ETA=0
+ THETA=0 KAPPA=0 VMAX=0 XJ=0 TOX=100n UO=600
+ PHI=.6 RS=46.07m KP=20.83u W=1.1 L=2u VTO=3.691
+ RD=8.065m RDS=400K CBD=2.329n PB=.8 MJ=.5 FC=.5
+ CGSO=2.208n CGDO=773.2p RG=1.927 IS=12.11f)
Обратим внимание, что при включении этого МОП-транзистора в описание схемы на входном языке программы PSpice (см. п. 3.2.6) нельзя указывать значения параметров L, W, AD, AS, PD, PS, NRD и NRS, так как часть из них уже приведена по директиве .MODEL, а для остальных использованы значения по умолчанию.
Параметры модели LEVEL=1 типичного КМОП-транзистора с кремниевым затвором при длине канала 3 мкм приведены в табл. 4.8.
Таблица 4.8
|
Параметр |
Обозначение |
n-канал |
p-канал |
Уровень легирования, Атом/см |
Na |
10 |
10 |
|
Толщина оксида, мкм |
TOX |
0,04 |
0,04 |
|
Работа выхода материал-кремний, В |
Fms |
-0,6 |
-0,1 |
Подвижность в канале, см |
 |
700 |
300 |
|
Топологическая длина канала, мкм |
L |
3 |
3 |
|
Глубина переходов стока и истока, мкм |
XJ |
0,6 |
0,6 |
|
Поддиффузия стока и истока, мкм |
LD |
0,15 |
0,15 |
|
Удельная емкость перекрытия на единицу ширины, пФ/мкм |
Cox |
0,35·10 |
0,35·10 |
|
Подгонка порогов: |
|
||
|
тип примеси |
Фосфор |
Фосфор |
|
|
эффективная глубина легирования, мкм |
Xi |
0,3 |
0,3 |
эффективная поверхностная концентрация, Атом/см |
Nsi |
2·10 |
0,9·10 |
|
Пороговое напряжение, В |
Vto |
0,7 |
-0,7 |
Степень легирования поликремнияя, Атом/см |
Nd |
10 |
10 |
|
Удельное сопротивление поликремния, Ом/кв. |
NRG |
20 |
20 |
Емкости сток–подложка, исток–подложка при нулевом смещении, пФ/мкм |
CJ |
8·10 |
2·10 |
|
Показатель степени |
MJ |
0,5 |
0,5 |
|
Показатель степени |
MJSW |
0,5 |
0,5 |
|
Удельная емкость исток-периферия, сток–периферия при нулевом смещении, пФ/мкм |
CJSW |
5·10 |
1,5·10 |
Плотность поверхностных состояний, Атом/см |
Qss/q |
10 |
10 |

где Qb – заряд обедненного слоя подложки.
В заключение сравним модели МОП-транзистора. На практике чаще всего используется модель первого уровня LEVEL=1. Она применяется в грубых расчетах, когда не требуется высокая точность. Отметим ее основные достоинства и недостатки:
– наименьшее время вычислений из всех моделей благодаря простоте уравнений;
– не учитывается зависимость подвижности носителей от электрического поля;
– не рассматривается подпороговый режим;
– не учитывается зависимость порогового напряжения от параметров L, W и Vds,;
– все емкости рассчитываются упрощенно,
– не учитывается неоднородность легирования.
Модель LEVEL= 2 основана на более точных теоретических построениях, однако ряд ее параметров трудно оценить по экспериментальным данным. При этом модель достаточно сложна, требует больших затрат на моделирование и возникают проблемы сходимости метода Ньютона–Рафсона при расчете режима по постоянному току.
Полуэмпирическая модель LEVEL=3 требует меньших вычислительных затрат и ее рекомендуется использовать для практических расчетов мощных вертикальных МОП-транзисторов с коротким каналом. Ее недостаток состоит в сложности оценки параметров математической модели по экспериментальным данным (но все равно это проще, чем для модели LEVEL=2).
Модель LEVEL=4 (BSIM1) основана на физике работы транзисторов с малыми размерами и рассчитана на получение параметров моделей изготовленных образцов с помощью специальной программы, управляющей работой тестера полупроводниковых приборов.
Модели LEVEL=5 и 6 (BSIM3) более точно описывают субмикронные МОП-транзисторы и непрерывно модифицируются. Из них модель LEVEL=6 предпочтительнее [59].